杏彩登录注册网页版:一文详解芯片上的集成技术
2024-03-16 11:06:49 1
封装内集成的基本单元是上一步完成的裸芯片或者小芯片Chiplet,我们称之为功能单元 (Func 从极简的视角来说,我们需要了解三类材料和三类工艺。导体、半导体、绝缘体虽然芯片上的材料非常多,现代集成电路中用到的材料几乎要穷尽元素周期表,所有的材料可以分为三大类:导体、半导体、绝缘体。导体负责传输电子,绝缘体负责隔离电子,其中最重要的自然是半导体,因为它是可变的,它有时候变成导体(导通),允许电子通过,有时候可变成绝缘体(关断),阻隔电子通过。并且,这种变化是可控的,通过设计特别的结构,并施加电流或者电压来控制。 加工艺简单来说就是在基底上增加材料,例如,离子注入,溅射、化学气相沉积CVD,物理气象沉积PVD等都可以归类为加工艺。 图形转移是三类工艺里面最多且最难的,因为每一步的加工艺或者减工艺基本都要以图形转移为依据。图形转移就是将设计的出来的图形,转移的晶圆上,涉及到的是掩膜、光刻、光刻胶。 产品是晶圆,晶圆被切割后就形成了芯片Chip或者芯粒Chiplet,为下一个层次的集成做准备。 封装内集成不会用到半导体的特性,因此封装内集成所用的材料主要分为两大类:导体和绝缘体,集成的主要目的就是将上一层次(芯片上的集成)所完成的芯片或芯粒在封装内集成并进行电气互联,形成微系统封装内集成的结果就是形成以SiP、先进封装为代表的功能单元,我们可以称之为微系统。 今天,PCB上基本都是双面安装元器件,板层也能达到几十层,高密度HDI板、刚柔结合板,微波电路板,埋入式器件板等都在广泛应用。 和封装内的集成一样,PCB上集成也不会用到半导体的特性,因此所用的材料主要分为两大类:导体和绝缘体。 芯片上的集成主要分为两大环节:器件制造和金属互连,也称为前段工艺FEOL和后段工艺BEOL。 器件制造就是在单晶硅片上通过光刻、刻蚀,离子注入,溅射、化学气相沉积,物理气象沉积、化学机械抛光、晶圆整平等工艺步骤,制造出被我们称为功能细胞的晶体管电阻电容二极管等。现在的5nm工艺可以在1mm²毫米的面积上制造出超过1亿只以上的晶体管。 下图所示为FinFET晶体管在显微镜下的照片,其中较高的白色横梁为栅极G,矮横梁为Fin,其宽度约为栅极宽度的0.67倍,栅极的两侧为源级S和漏极D。 晶体管层制造好后,通过钨等金属制造接触孔contact连接晶体管和首层布线,然后通过多层金属布线和过孔进行电气互连,早先的芯片用铝布线,现在的芯片多用铜布线。 下图所示为芯片上的金属互连线在显微镜下的照片,可以看出多层布线结构,目前的工艺可以支持超过10层以上的金属布线。 下图给出了前段工艺FEOL和后段工艺BEOL的结构示意图,先在硅基底上制造晶体管,然后通过金属互连将它们连接起来并引出到芯片的PAD。 通过键合线Bond Wire将芯片的PAD连接到封装基板或者引线框架,然后再连接到外部引脚,通过引脚的排列方式,可分为BGA,CGA,QFP,LCC,SOP,DIP等多种封装形式。 为了提高封装内的功能密度,需要在封装内集成更多的功能单元,传统的键合线连接方式已经无法满足要求,人们发明出多种多样的先进封装技术,下面我们就看看其中最为典型的技术。 在芯片表面布线,通过RDL (Redistribution Layer) 重新布线层将PAD连接到占位更宽松的位置并制作凸点Bump,我们称之为XY平面的延伸。 然后通过Bump,芯片就可以直接安装在基板上了,这种工艺被称为倒装焊 Flip Chip,看看下面的图,你就会明白为啥叫倒装了。 倒装焊芯片由于无法堆叠,因此无法进行Z轴的延伸,人们就发明出了能打穿整个芯片体的通孔技术,被称作TSV(Through Silicon Via)技术。 下图就是芯片上的TSV示意图,通过TSV可将芯片上下表面通过金属导体连接起来,为芯片堆叠做好了准备。 芯片在封装内集成完成后,尺寸还不够大,另外有些分立元器件、例如大的电容、变压器等也无法集成到芯片封装内部,因此,对于电子产品来说,PCB始终是必不可少的。 PCB的制造工艺和有机基板类似,其布线密度没有有机基板高,结构也相对比较简单。PCB上多采用通孔结构,虽然现在高密度HDI板也采用了盲埋孔结构,但通孔由于结构简单,成本低廉,在PCB中得到了普遍的应用。下图所示为6层通孔结构PCB,通过PCB,可将器件固定并进行电气互连。 晶体管(NMOS或PMOS)在硅基底上制造完成后,通过接触孔连接到芯片上的金属布线,再连接到芯片的Pad,然后通过RDL连接到3DTSV,通过uBump连接到硅转接板上的RDL和2.5DTSV,再通过Bump连接到封装基板,然后通过封装基板上的连线和过孔连接到BGA,最后连接到PCB上的布线和过孔。 声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。举报投诉 1、2、3、ARM嵌入式开发之ARM指令与ARM汇编入门4、ARM嵌入式开发之ARM汇编高级教程与APCS规范 (Timer)、USB、A/D转换、UART、PLC、DMA等周边接口,甚至LCD驱动电路都整合在单 种通用的接地方法可以参考呢?答案很明确,没有。任何学习的过程都没有捷径,只有耐心的他是学习才是最后的路径。接地方式←接地目的 来源:nick_5541电源产品在做验证时,经常会遭遇到电磁干扰(EMI)的问题,有时处理起来需花费非常多的时间,许多工程师在对策电磁干扰时也是经验重于理论,知道哪个频段要对策那些组件,但对于理论 /Boone来源:中关村在线,智慧产品圈等中兴事件引起了全球的轰动,大家的目光聚集在服务器、计算机、存储底层 )(2)模块级在整个系统中分为很多功能模块各司其职。有的管理电源,有的负责通信,有的负责显示,有的负责发声,有的负责统领全局 ;Ø引脚数。引脚数越多,越高级,但是工艺难度也相应增加;其中,CSP由于采用了FlipChip 本电子书对封装介绍的非常详细,所以和大家分享。因为太大,没有上传。请点击下载。[此贴子已经被作者于2008-5-12 22:45:41编辑过] 。生物科技:人类基因图谱计划的目的是对内的脱氧核糖核酸(DNA)中约80000个基因进行译码;其中主要利用生物 ,分享你的设计感悟、设计实例以及设计技巧。月月有礼品,季季有惊喜,希望藉由原创博客大赛的平台扬起您远航的风帆,成为受网友追捧的电子设计达人。本活动旨在建立 的中心。不过,当今天人们在谈论SoC时,他们实际谈论的只是部分系统——仅是把数字基带与数据转换器、 电路封装更加严格。为了满足发展的需要,BGA封装开始被应用于生产。BGA也叫球状引脚栅格阵列封装 多种电子功能,具有小型化和提高系统性能的优势,以取代体积庞大的分立无源元件。文章主要介绍了什么是 ieee电脑设计与测试 2010.9 2020-1-7lpda的通讯媒体为电磁波,其能力毕竟有限,随着互联网的发展,和光学理论的应用,取长补短,则优 的概念。电脑机箱主板又叫主机板(mainboard)、系统板(systemboard)或母板(motherboard);它分为商用主板和工业主板两种。它安装 用的是AMD2587,但是老师好像不太满意其价格,有别的吗?廉价的?请请问各位大侠多多推荐,最好能顺带提供datasheet,非常感激! 种带微处理器的,兼有信息检测、信息处理、信息记忆、逻辑思维与判断功能的传感器。以下重点探讨智能传感器的应用和发展。 磁件(Integratea Magnetics,简称IM)滤波电路的专利申请,其中,IM是用于滤波电路中的耦合电感,其后的近40年间,磁 显著降低了千兆以太网连接所需的器件成本、电路板空间及功耗。BroadCom57系列中的bcm5703网卡 整合触摸屏(RTP为框贴,CTP为OCA全贴合),并把用户CPU核的IO、UART、CAN、AD、PWM等接口引出到FPC接口上的产品,极其适合结构要 的实用型LED产品已经问世。其综合光学性能可以与Lumileds公司的相应瓦数的LED产品相比。
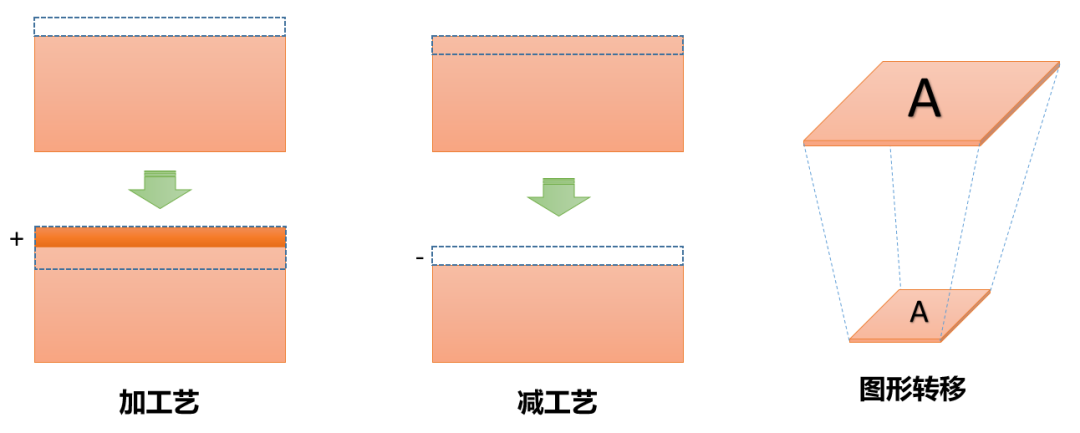
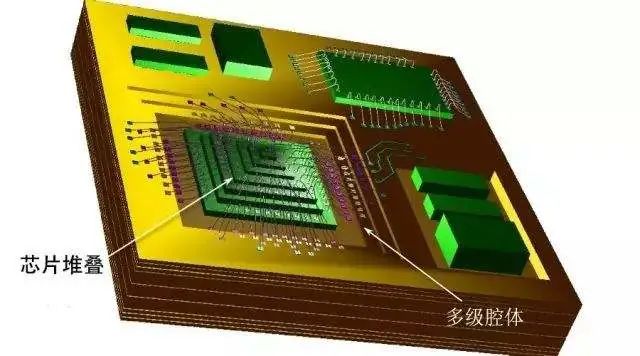


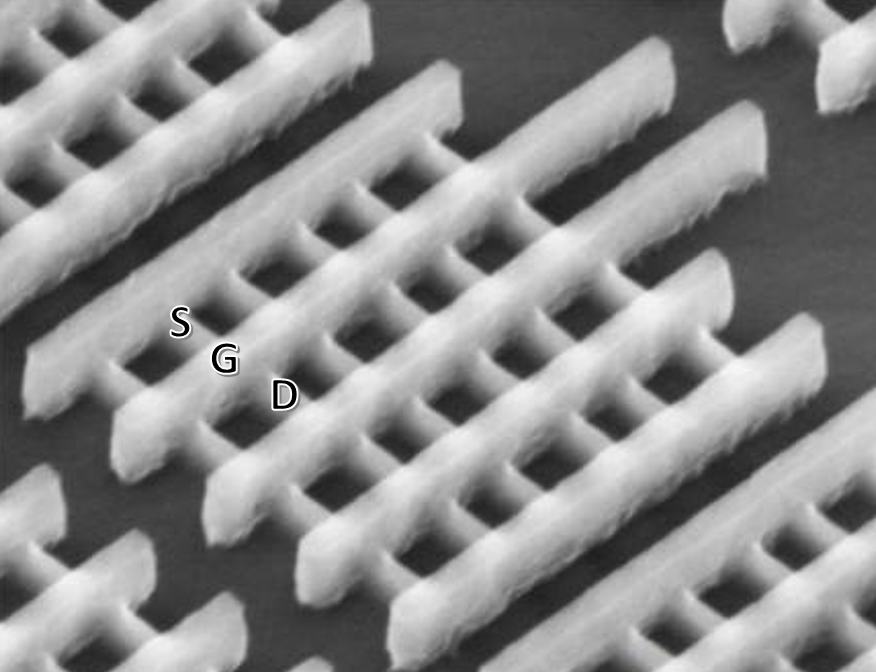
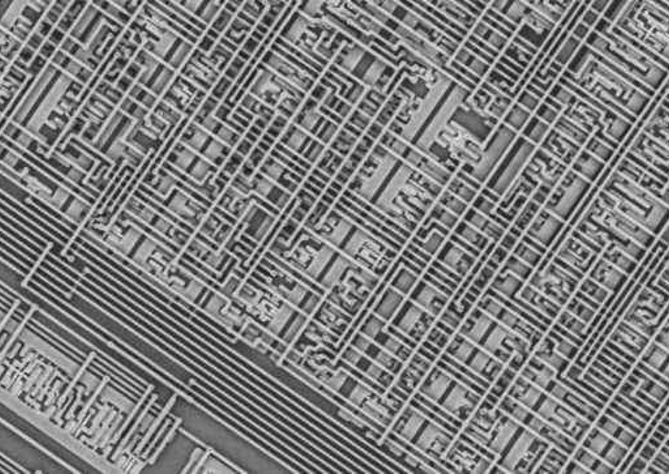
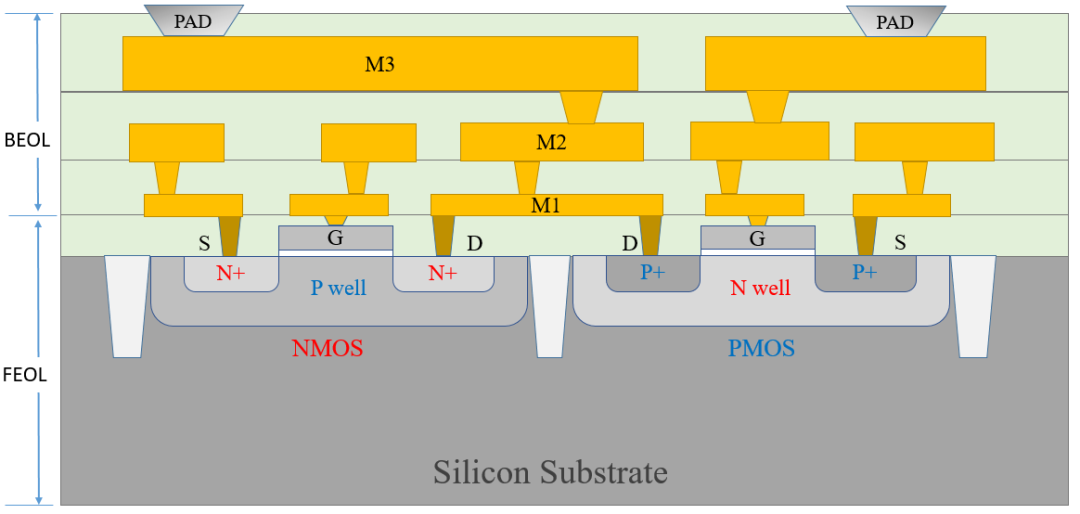
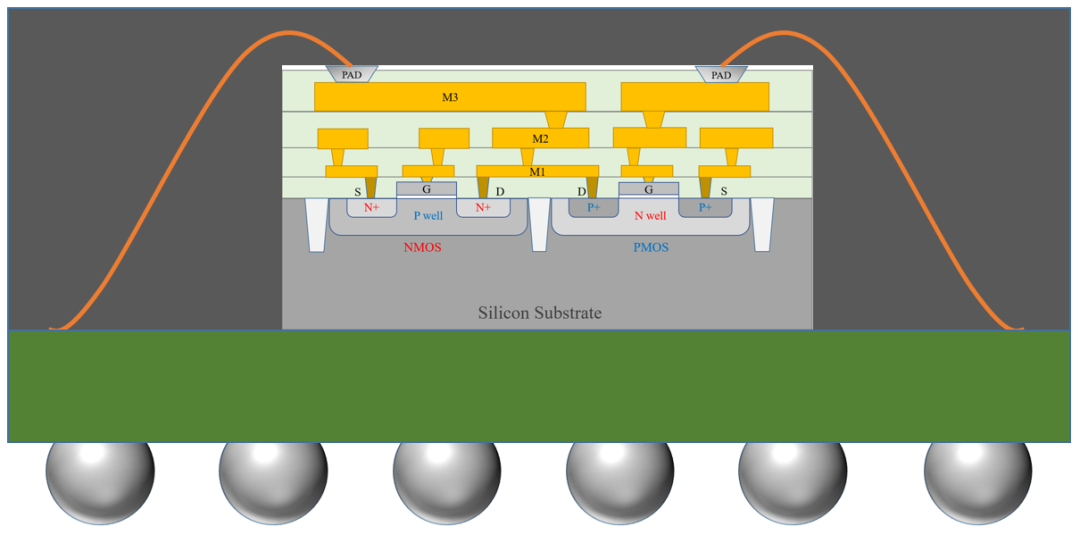
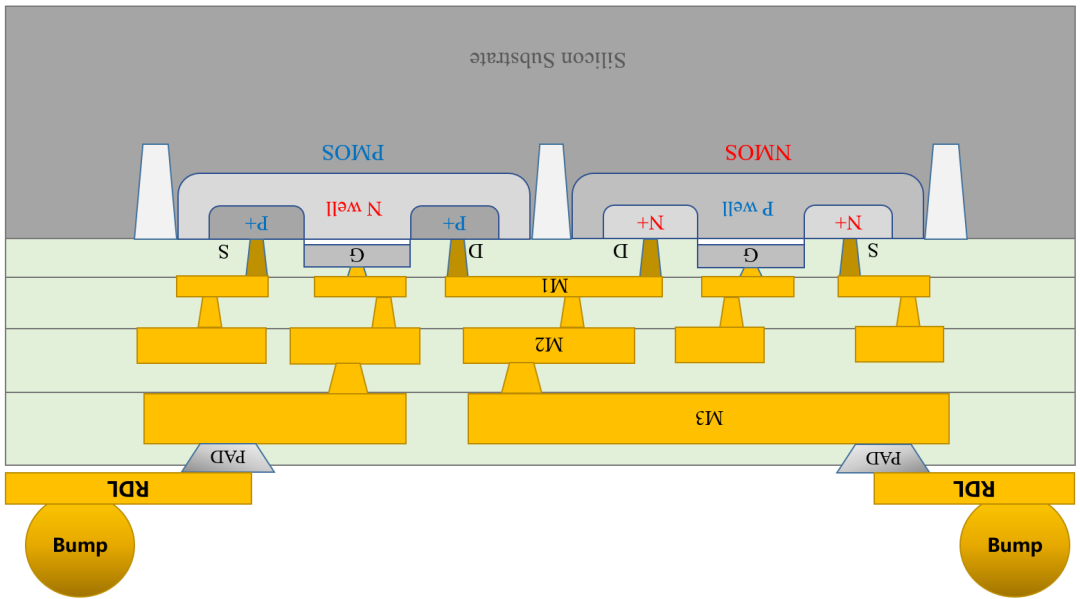

 咨询热线:13827035023 (李先生)
咨询热线:13827035023 (李先生)
